IC 기판 (IC 탑재판) 은 주로 IC (IntegratedCircuit) 를 탑재하는 데 사용되며, 내부에는 칩과 회로판 사이의 신호를 전달하기 위한 선로가 배치되어 있으며, 탑재된 기능 외에도 IC 기판은 회로 보호, 전용선, 발열 경로 설계, 제로 부품 모듈화 표준 구축 등 추가 기능이 있다.IC기판은 HDI회로기판의 기초에서 발전한것으로서 량자는 일정한 관련성이 존재하지만 IC기판의 과학기술문턱은 HDI회로기판과 일반PCB회로기판보다 훨씬 높다.IC기판은 고급의 PCB로 리해할수 있으며 고밀도, 고정밀도, 고발수, 고성능, 소형화 및 박형화 등 특점이 있으며 여러가지 기술매개변수에서 모두 더욱 높은 요구를 갖고있다. 특히 가장 핵심적인 선폭/선거리매개변수이다.
IC 기판은 트랜지스터 패키지의 핵심 재질이다.집적회로산업사슬은 칩설계, 웨이퍼제조와 포장테스트 등 세가지 고리로 나뉜다.패키지는 칩을 보호하고 열전도성을 강화하는 역할을 할 뿐만 아니라 외부의 회로와 칩 내부를 연결하여 고정된 칩의 역할을 할 수 있다.IC 패키징 기판 (IC Package Substrate, 약칭 IC 기판, 패키징 기판이라고도 함) 은 패키징 테스트 단계의 핵심 담체로 IC와 PCB 사이의 신호 연결을 구축하는데 사용되며, IC 기판은 회로를 보호하고 선로를 고정하며 여열을 발산하는 역할도 할 수 있다.
IC 기판은 메인스트림 패키지 기술에 적용됩니다.트랜지스터 칩 패키지는 여러 세대의 변천을 거쳤으며, 패키지 기술로는 DIP 패키지(이열 직삽식 패키지 기술), SOP 패키지(소형 패키지), QFP 패키지(소형 사각형 평면 패키지), PGA 패키지(핀 그리드 배열 패키지 기술), BGA 패키지(용접구 배열 패키지), SIP 패키지(시스템급 패키지)로 분류된다.과학기술의 교체와 업그레이드는 현재의 포장면적과 칩면적을 1에 접근할수 있게 한다.
BGA (Ball grid array) 패키지의 경우 다른 패키지 칩의 핀이 칩 주위에 분포되어 있는 것과 달리 BGA 핀은 패키지의 하단에 있어 I/O 단자 간격이 커지고 수용 가능한 I/O 수가 많아진다.BGA 패키지는 완제품률이 높고 전기특성이 좋으며 고주파회로에 적용되는 등 특점으로 현재 주류의 패키지기술의 하나로 되였다.BGA를 기반으로 CSP, MCM 및 SIP와 같은 고밀도 IC 패키징 파이프가 점차 파생됩니다.첨단 패키징 기술은 집적 회로의 미세화, 복잡화, 집적화의 특징에 더욱 영합하며, IC 기판은 고정밀도, 고밀도, 소형화 및 박형화의 특징으로 인해 주류 패키징 기술에 널리 응용되고 있다.
IC 기판은 품종이 다양하고 응용이 광범위하다.패키지된 파이프, 가공 재료 및 응용 분야에 따라 분류할 수 있습니다.
1. 패키징 파이프라인에 따라 IC 기판은 BGA 패키징 기판, CSP 패키징 기판, FC 패키징 기판, MCM 패키징 기판으로 나뉜다.
2. 포장재질에 따라 분류하면 IC기판은 경질포장기판, 유연성포장기판과 도자기포장기판으로 나뉜다.강성 패키징 기판은 주로 BT 수지 또는 ABF 수지로 만들어지며 CTE (열팽창 계수) 는 약 13~17ppm/°C입니다.플렉시블 패키지 기판은 주로 PI 또는 PE 수지로 만들어지며 CTE는 약 13~27ppm/°C입니다.세라믹 패키징 기판은 주로 산화 알루미늄, 질화 알루미늄 또는 탄화규소와 같은 세라믹 재료로 만들어지며 상대적으로 낮은 CTE를 가지고 있으며 약 6~8ppm/°C입니다.
3. 응용분야에 따라 IC기판은 메모리칩포장기판, 마이크로컴퓨터전기시스템포장기판, 무선주파수모듈포장기판, 프로세서칩포장기판과 고속통신포장기판 등으로 나뉜다.
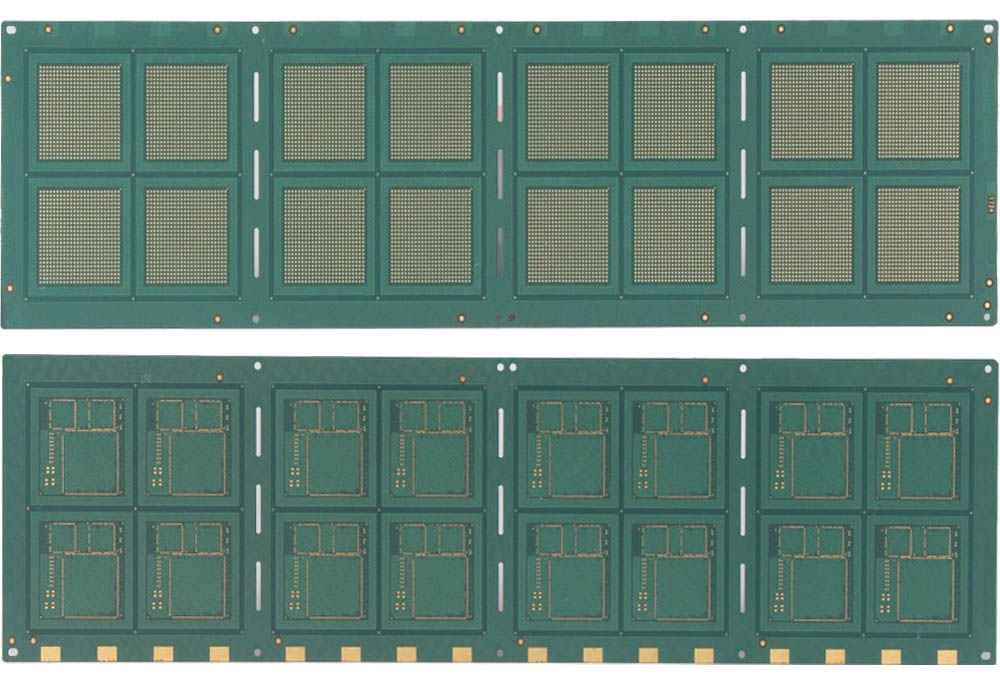
BGA 패키지 기판
IC 기판은 일반 PCB 및 HDI보다 매개변수에 대한 요구가 훨씬 높습니다.선폭/선거리를 기준으로 정원을 측정하면 일반 IC 기판 제품은 20에 도달할 수 있다20μ m/20μ m, 하이엔드 IC 기판 선가중치/선가중치가 10μ m/10μ m、5μ m/5μ m, 일반 성능의 PCB 제품 선가중치/선가중치 50μ m/50μ m 이상.
IC 기판 제작 공정은 SAP (반가성법) 와 MSAP (개량반가성법) 로 선폭/선거 25 미만 생산에 사용된다μ m, 공정이 더욱 복잡한 제품.SAP와 MSAP는 기판에 얇은 구리층을 코팅한 뒤 그래픽 디자인을 하고 필요한 두께의 구리층을 도금해 종자 구리층을 제거하는 원리가 비슷하다.두 공정의 기본 차이는 종자 구리 레이어의 두께입니다.SAP 공정은 얇은 화학 구리 도금 코팅 (1.5um 미만) 에서 시작되고 MSAP는 얇은 동박 (1.5mum 이상) 에서 시작됩니다.
감성법은 PCB 회로판 제작 방법으로, 복동판에 먼저 판 전체에 구리를 도금하여 선로 및 도통구멍을 보호하고, 필요하지 않은 구리 껍질을 식각하여 선로 및 도통구멍의 구리를 남기는 것으로 약술한다.감성법의 가장 뚜렷한 결함은 측식성이 높다는 것이다. 즉 동층은 아래로 식각하는 과정에서도 측면을 식각하여 감성법의 정밀도에 제한을 받게 된다.따라서 감성법의 최소 선가중치 / 선가중치는 50까지 제한됩니다.μ m, 선가중치 / 선가중치<50μ m시, 감성법은 양률이 너무 낮아 사용할 수 없습니다.
IC 기판 (IC 탑재판) 생산 공정에는 여러 가지 과학 기술 난점이 존재하는데, 전 공정 재질 상승 제어, 도형 형성, 구리 도금, 용접 방지 공정과 표면 처리 등 다섯 가지 방면에서 구현된다.