HDI PCB 공정은 전통적인 듀얼 패널을 심판으로 하여 끊임없이 쌓이고 쌓임으로써 만들어진다.끊임없이 쌓이는 이 공정의 회로 기판은 또한 쌓인 다층 기판(Build-up Multilayer, BUM)이라고도 부른다.HDI PCB는 기존 회로 기판에 비해'가볍고, 얇고, 짧고, 작다'는 장점이 있다.
HDI PCB의 층간 전기 연결은 전기를 전도하는 통공, 매공 및 맹공 연결을 통해 이루어지며, 그 구조는 일반적인 다층 회로 기판 제조 공정과 다르다. HDI PCB 회로 기판 제조 공정에는 마이크로 매몰 맹공과 레이저 직접 드릴이 많이 사용되며, 표준 PCB 제조 공정은 일반적으로 기계 드릴을 사용하기 때문에 층수와 고폭비는 종종 기존 표준 PCB보다 낮아진다.HDI PCB는 일반 PCB에 비해 회로 밀도가 높고 부피가 작으며 무게가 가벼운 것이 가장 큰 특징이다.
iPCB는 HDI PCB의 모범 빠른 밀링을 지원하는 고정밀 HDI 회로 기판 모범 및 대량 제조를 제공합니다.다음은 iPCB의 공정 능력표입니다. 저희에게 연락하신 것을 환영합니다.
HDI PCB 정의
1. HDI 구멍: 레이저 드릴로 제작된 도통 구멍을 가리키며 H구멍 또는 맹공 또는 뇌사공이라고도 한다.
2, 3단계 HDI PCB: 적어도 L1/2/3/4 또는 L1/4 3단계 HDI 구멍이 함유된 PCB (보드에 1/2단계 HDI 구멍이 동시에 있을 수도 있고 1/2단계 HDI 구멍이 없을 수도 있음) 를 가리키며, 일반적으로 이 보드의 구조는 3+X+3, 다단계판은 이에 따라 유추된다.
3. 다단계 보드 HDI PCB: 3단계 또는 3단계 이상의 HDI PCB를 가리키며, 일반적으로 이 보드 구조는 n+X+n, (n≥3)로 표현된다.
4. Anylayer 임의 연결 HDI 회로 기판: 인접한 각 층에 HDI 구멍이 1단계만 포함된 PCB 기판을 말한다.일반적으로 이 판의 구조는 n+2+n으로 표현되며, 이중 패널에서 시작하며, 이에 따라 중첩하여 압판 및 라듐 구멍을 뚫는다.
5, 3 단계 및 Anylayer HDI PCB 구조의 다양한 HDI 계층 정의는 다음과 같습니다.
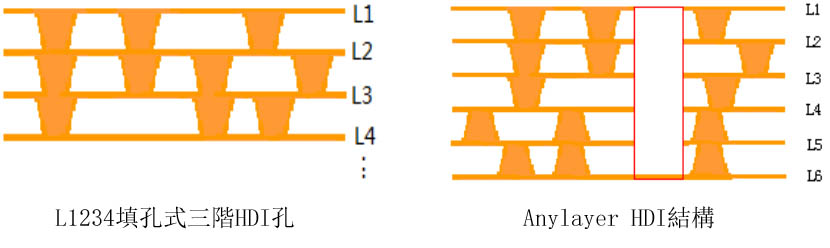
HDI 패브릭
3 단계 블라인드 설계의 생산 공정 L04/05, L06/07
오프닝 → IDF(전처리 → 패치 → 노출 → DES) → IAOI
계단식 3단계 맹공 설계의 생산 공정 L03/08
L04/05, L06/07 종려화 → L03/08 배판/층압 → CFM 드릴링 표적/압판 후처리 → 감동 → 2차 종려화 → LDD 레이저 드릴링 → 기계 드릴링 → 연마판 → 제교 → 침동 플래시 도금 → 전판 도금 → L03/08 IDF(전처리 → 패치 → 노출 → DES) → L03/08OAOI
펀치식 3단계 블라인드 설계의 생산 공정(L03/08)
L04/05, L06/07 종려화→L03/08 배판/층압→CFM 표적/압판 후처리→감동(1)→2차 종려화→LDD 레이저 드릴링→연마판→제교→침동 플래시 도금→수평 구멍 도금→X-RAY 표적 드릴링→감동(2)→기계 드릴링→연마판→제교→침동 플래시 도금→AOS 전처리→L03F → IDE/08 → L03F
계단식 3단계 맹공 설계의 생산 공정 L02/09
L02/09 종려화 → L02/09 배판/층압 → CFM 드릴링 표적/압판 후처리 → 2차 종려화 → LDD 레이저 드릴링 → 연마판 → 제교 → 침동 플래시 도금 → 전판 도금 → L02/09IDF (전처리 → 패치 → 노출 → DES) → L02/09 내층 AOI
계단식 3단계 맹공 설계의 생산 공정 L01/10
L01/10 종려화 → L01/10 배판/층압 → CFM 드릴링 표적/압판 후처리 → 감동 → 2차 종려화 → LDD 레이저 드릴링 → 기계 드릴링 → 연마판 → 제교 → 침동 플래시 도금 → 전판 도금 → L01/10 ODF(전처리 → 패치 → 노출 → DES) → L01/10OAOI
펀치식 3단계 블라인드 설계의 생산 공정 L02/09
L02/09 종려화 → L02/09 배판/층압 → CFM 드릴링 표적/압판 후처리 → 2차 종려화 → LDD 레이저 드릴링 → 연마판 → 제교 → 침동 플래시 도금 → 수평 충전 도금 → L02/09 IDF (전처리 → 패치 → 노출 → DES) → L02/09 내층 AOI
펀치식 3단계 블라인드 설계의 생산 공정(L01/10)
L01/10 종려화 → L01/10 배판/층압 → CFM 드릴링 표적/압판 후처리 → 감동(1) → 2차 종려화 → LDD 레이저 드릴링 → 연마판 → 제교 → 침동 플래시 도금 → 수평 충전 도금 → X-RAY 드릴링 표적 구멍 → 감동(2) → 기계 드릴링 → 연마판 → 제교 → 침동 플래시 도금 → 완전 도금 → L01/10F → 완전 도금 → ODE → L01/10 → OD
Anylayer의 생산 공정(10 계층 Anylayer의 경우)
{L5/6 재료 공급 - L5/6 기계 드릴링 (드릴링 공구 구멍) → 징판 테두리 (라운드) → L5/6IDF (습막으로 CFM 창문 열림) 또는 2차 종려화 → L5/6 레이저 드릴링 - L5/6 젤 제거 → L5/6 침동 플래시 도금 → L5/6 수평 충전 전기 도금 → L5/6 종려화 → L5/6 L5/6 L5/6 종려화 시추 → L5/6 L5/6 종려화 시추 → L5/6 L5 → L5/6 종려화 시추판 → L5/6 L5/6 → L5/6 종려화 레이저 드릴(LDD)→ 맷돌-제접→침동섬광도금→수평채공→IDF(전처리-패치-노출-DES)→IAOI}→{L3/8종려화→배판압판→CFM드릴표적공-압판후처리→이차종려화→레이저드릴(LDD)→맷돌-제접착→침동섬광도금→수평채공→IDF(전처리-DES){L2/9 종려화 → 배판 압판 → CFM 드릴링 표적 구멍 - 압판 후 처리 → 2차 종려화 → 레이저 드릴링(LDD) → 연마판 - 젤 제거 → 침동 플래시 도금 → 수평 충전 → IDF(전처리 - 패치 - 노출 - DES) → IAOI} → L1/10 종려화 → 배판 압판 → CFM 드릴링 → 압판 → 압판 → 압판 → 압판 → 압판 → 압판 → 압판 → 압판 후 압판 → 압판 압판 후 압판 → IDFDDD(레이저 절)→ 연마판 → 제접 → 침동 플래시 도금 → 수평 펀치 도금 → XRAY 드릴링 표적 구멍 → 감동 (2) → 기계 드릴링 → 연마판 - 제접 → 침동 플래시 도금 → 전판 도금 → 전판 도금 / 통맹공 합도금 (레이저 드릴링 (LDD) → 기계 드릴링 → 연마판 → 제접착 → 침동 플래시 도금 → 수직 펀치 도금 → 수평 도금 → ODES - AOF} - DF
후공정은 전형적인 생산 공정을 밟고, 외판의 표면 코팅과 검측 생산 공정을 거친다.
그린오일 → 문자 → 침니켈 골드 → 임피던스 테스트 → 밀링 외형 → ETEST → 최종 검사 → FQA 추출 검사 → 포장
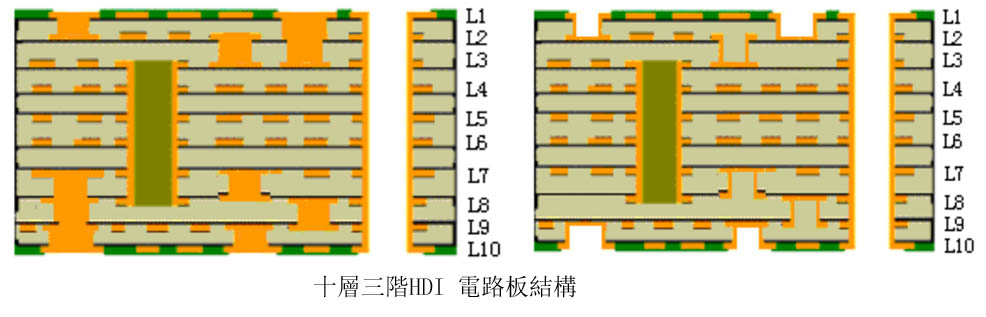
10층 3단계 HDI 회로기판 구조
현 단계에서 iPCB의 HDI PCB 공정 능력 과학기술은 이미 최고 층수를 38층, 맹공 계수 1단계에서 7단계 또는 anylayer 임의 연결 HDI, 최소 공경 0.05mm로 돌파하였다.